2026-04-13 0
在半導體產業國產替代的浪潮中,IC集成電路封裝作為芯片制造的后道核心環節,直接決定芯片的良率、尺寸一致性與終端可靠性,而劃片機作為封裝環節的關鍵裝備,承擔著將整片晶圓精準分割為獨立芯片裸片(Die)的核心使命,是銜接晶圓制造與芯片集成的“橋梁”。長期以來,高端劃片機市場被日本DISCO等國際巨頭壟斷,成為制約我國半導體產業鏈自主可控的關鍵瓶頸。深耕這一領域的國產企業憑借自主研發突破海外技術壁壘,推出的全系列IC封裝劃片機,精準適配IC集成電路封裝全場景需求,以高精度、高效率、高兼容性的核心優勢,為國產IC封裝產業賦能,助力產業鏈實現自主可控升級。
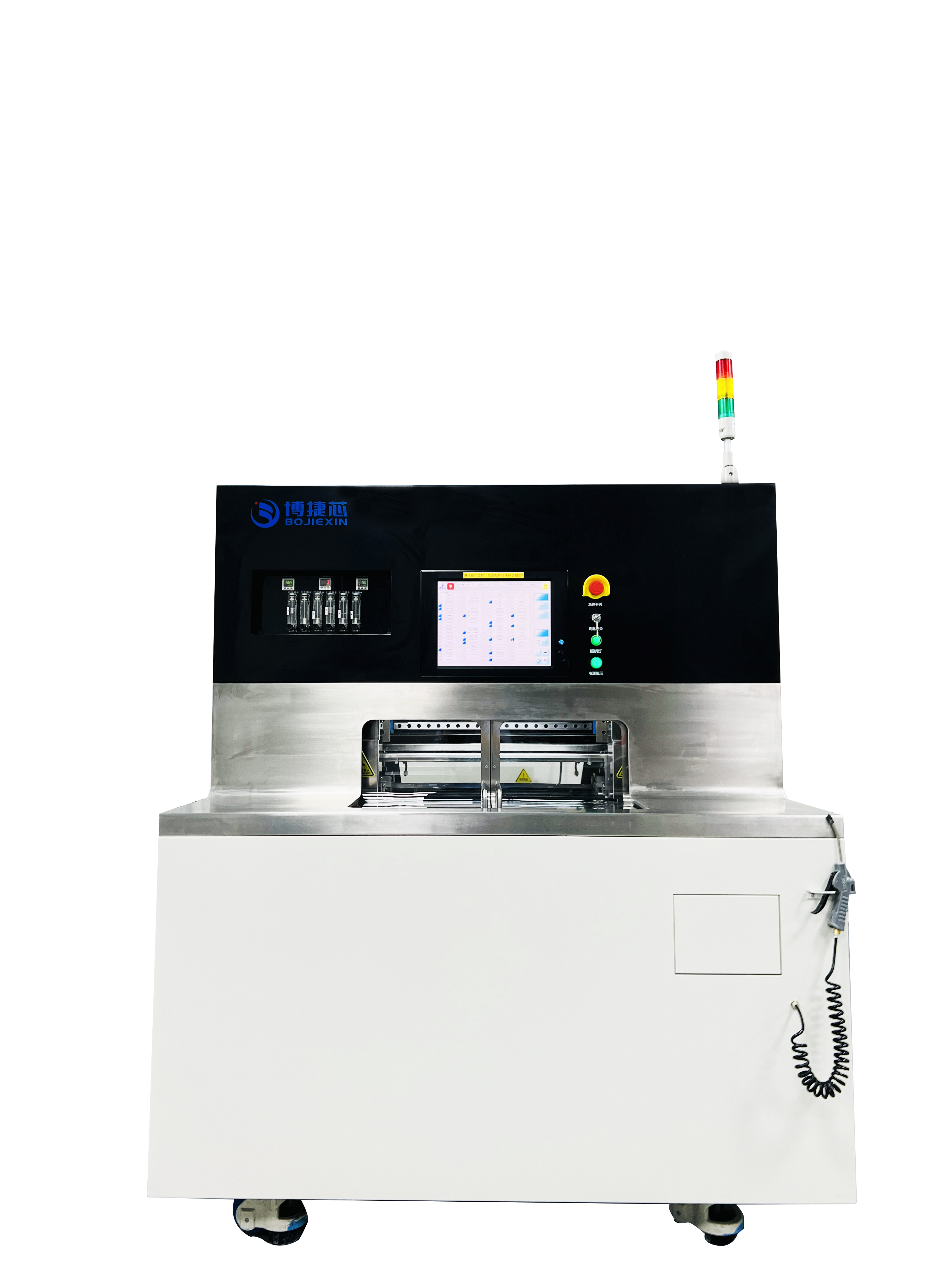
一、IC集成電路封裝核心需求:劃片機是關鍵支撐
IC集成電路封裝的核心目標是保護芯片、實現電氣連接并提升散熱性能,而劃片工序作為封裝的前置關鍵步驟,直接影響后續封裝工藝的效率與成品質量。隨著半導體技術向小型化、高密度、高性能方向迭代,IC封裝對劃片機提出了更為嚴苛的要求:一是精度要求,需實現亞微米級切割,精準沿劃片道(Scribe Lane)切割,避免損傷芯片電路,控制崩邊、掉渣等缺陷;二是效率要求,適配量產需求,縮短單批次加工周期,降低單位芯片制造成本;三是兼容性要求,可適配6-12英寸不同規格晶圓,兼容硅、碳化硅(SiC)、氮化鎵(GaN)等多種材料,適配Flip Chip、CSP、WLCSP等先進封裝工藝;四是穩定性要求,長期連續運行無故障,保障生產流程順暢,降低停機損耗。
傳統劃片機存在精度不足、兼容性差、效率偏低等痛點,尤其在超薄晶圓(<50μm)、硬脆材料切割中易出現崩邊、器件電性失效等問題,難以滿足高端IC封裝的量產需求。國產精密切片機針對這些行業痛點,通過技術創新實現全方位突破,成為國產IC封裝企業的優選裝備,徹底解決了傳統國產劃片機“精度不足、穩定性差、適配性弱”的困境。

二、國產劃片機核心優勢:精準適配IC封裝全場景
依托精密切割領域的深厚技術積累,國產全系列IC封裝劃片機涵蓋半自動、全自動等多種類型,可精準適配不同規模IC封裝企業的生產需求,其核心優勢集中體現在以下四大方面,完美契合IC集成電路封裝的核心訴求:
(一)亞微米級精度,保障封裝良率
這款精密切片機采用進口直線電機+光柵尺閉環系統,搭配空氣靜壓主軸,將切割精度控制在±1μm級別,定位精度可達0.001/5mm,崩邊尺寸穩定控制在5μm以內,有效避免切割過程中芯片電路損傷、邊緣崩裂等問題,從源頭提升IC封裝良率。設備搭載高精度CCD視覺對位系統,對位精度達±3μm,可自動識別晶圓Mark點與劃片道,實現不規則切割路徑規劃,降低人工校準誤差,尤其適配高密度、小尺寸IC芯片的切割需求,解決了傳統劃片機精度不足導致的芯片報廢問題。例如,在碳化硅芯片封裝切割中,應用該設備后,芯片劃片良率可從89%提升至99.2%,缺陷修復成本降低70%。
(二)高效量產設計,降低封裝成本
針對IC封裝量產需求,這款IC封裝劃片機采用創新雙軸并行設計,部分型號實現“雙工位同步切割”,效率較傳統單軸設備提升30%-50%;同時優化切割工藝,搭配高壓氣液兩相噴霧冷卻系統,快速帶走加工熱量、抑制熱應力,既提升切割速度,又減少后續清洗、修復環節,單批次加工周期縮短40%以上。以12英寸碳化硅晶圓加工為例,該設備可將單晶圓加工時間從6小時壓縮至20分鐘,單位芯片劃片成本降低60%。此外,設備的圖形化編程界面可一鍵生成切割程序,操作便捷,大幅降低人工成本,進一步助力IC封裝企業實現降本增效。
(三)全場景兼容,適配多元封裝需求
這款劃片機覆蓋6-12英寸全規格晶圓,可高效處理硅、碳化硅、氮化鎵、低k材料等多種IC封裝常用材料,完美適配QFN/DFN、Flip Chip、CSP、WLCSP、Fan-Out等主流及先進封裝工藝,可滿足存儲芯片、功率芯片、射頻芯片、MEMS芯片等各類IC產品的劃片需求。針對超薄晶圓(50-100μm)、硬脆材料等特殊加工場景,設備采用柔性真空吸附技術,消除裝夾預應力與切削應力的疊加效應,搭配“激光預裂+精密切割”復合工藝,從根源上減少應力集中,破解硬脆材料切割崩邊難題,適配高端IC集成電路封裝的多元化需求。同時,設備可根據客戶需求定制顯微鏡倍率、刀盤尺寸等參數,進一步提升場景適配性。
(四)智能穩定運行,保障生產連續性
這款精密切片機融入智能化管控技術,集成力傳感器、紅外測溫儀等實時監測模塊,可動態捕捉切削力波動、加工溫度變化等關鍵參數,當檢測到應力異常時,系統可自動調整進給速度或暫停加工,避免缺陷擴大。設備搭載數據追溯系統,實時記錄切割參數與設備狀態,無縫對接MES系統,助力IC封裝企業實現智能制造與質量追溯。此外,設備采用高剛性運動平臺與優質核心零部件,經過嚴格的穩定性測試,可實現長期連續運行,故障率低,大幅減少停機損耗,保障IC封裝生產流程的順暢性,為企業穩定量產提供堅實支撐。
三、劃片機在IC封裝中的典型應用場景
依托全場景適配能力與核心技術優勢,這款IC封裝劃片機已廣泛應用于各類IC集成電路封裝場景,得到長電科技、通富微電、中芯國際、京東方等頭部企業的量產驗證,其典型應用場景包括:
(一)存儲芯片封裝劃片
存儲芯片(如NAND、DRAM)電路密度極高,對劃片機精度與尺寸一致性要求嚴苛。這款精密切片機憑借亞微米級切割精度與穩定的運行性能,可精準切割存儲芯片晶圓,將劃片道寬度從傳統的150μm縮減至80μm以內,單晶圓可產出芯片數量提升10%-15%,有效降低硅材料浪費,同時避免切割過程中出現的電路損傷,保障存儲芯片的讀寫性能與可靠性,適配存儲芯片高密度、小型化的封裝趨勢,助力存儲芯片產業實現量產升級。
(二)功率芯片封裝劃片
功率芯片(如IGBT、MOSFET)多采用碳化硅、氮化鎵等硬脆材料制造,切割過程中極易出現崩邊、掉渣等缺陷,影響芯片散熱性能與使用壽命。這款IC封裝劃片機針對硬脆材料加工特點,升級金剛石刀具配置,采用800-1200目細粒度磨料與樹脂結合劑組合,配合動態平衡校正技術,將刀具跳動量控制在0.01mm以內,實現切削力的均勻分布,可高效處理功率芯片晶圓的精密切割,保障芯片邊緣平整、無損傷,提升功率芯片的散熱效率與長期可靠性,適配新能源、汽車電子等領域對功率芯片的高端需求。
(三)先進封裝工藝劃片
隨著3D IC堆疊、TSV(硅通孔)等先進封裝技術的普及,IC封裝對劃片機的精度、應力控制能力提出了更高要求。這款精密切片機可適配Flip Chip、WLCSP、Fan-Out等先進封裝工藝,通過精準的路徑規劃與應力控制,實現超薄晶圓、堆疊晶圓的無應力切割,避免層間剝離與崩邊風險,同時保障芯片尺寸的一致性,為先進封裝工藝的規模化量產提供核心裝備支撐。其中,其BJX8260高精度型號在京東方Mini/Micro LED COB顯示產品擴產項目中成功中標,標志著其在先進封裝相關領域的技術實力獲得頭部企業認可。
(四)通用IC封裝劃片
針對消費電子、物聯網等領域的通用IC芯片(如MCU、射頻芯片),這款劃片機憑借高性價比、高兼容性的優勢,可適配6-8英寸晶圓的批量切割需求,兼顧效率與精度,大幅降低中小企業的設備投入成本與生產成本。設備操作便捷,無需專業技術人員即可快速上手,同時提供完善的售后技術支持,助力中小企業實現IC封裝的高效生產,推動通用IC芯片產業的規模化發展。

四、產業價值:助力IC封裝國產替代,賦能產業鏈升級
在半導體產業國產替代的大背景下,這款IC封裝劃片機的推出與廣泛應用,不僅打破了國外巨頭對高端劃片機市場的壟斷,為國內IC封裝企業提供了可靠的國產化選擇,降低了供應鏈對外依賴風險,更推動了國產IC集成電路封裝產業的技術升級與效率提升。截至目前,該設備已服務京東方、華星光電TCL、中芯國際、三安光電等知名企業,2024年出貨量同比增長300%,帶動國產劃片機全球市場份額提升至15%,成為國產高端劃片機領域的引領者。
五、IC封裝劃片機選型技巧
對于IC封裝企業而言,選擇適配的劃片機是提升生產效率、保障產品良率的關鍵,結合行業實踐總結3個核心選型技巧,助力企業精準選型:一是看精度與穩定性,優先選擇切割精度達±1μm級別、定位精度高且故障率低的設備,尤其針對高端IC封裝場景,需重點關注崩邊控制能力;二是看兼容性,結合自身晶圓規格(6-12英寸)、材料類型(硅、碳化硅等)及封裝工藝,選擇適配性強、可靈活定制的設備;三是看性價比,兼顧設備投入成本、運行成本與售后支持,優先選擇操作便捷、可快速上手,且能提供完善技術服務的產品,降低企業生產與管理成本。
作為國產半導體精密切割設備的標桿力量,相關企業始終以技術創新為核心,持續優化劃片機產品性能,聚焦IC集成電路封裝領域的核心需求,不斷突破技術瓶頸,推動劃片機技術向更高精度、更高效率、更智能化的方向發展。未來,將繼續深耕IC封裝裝備領域,加強與國內IC封裝企業的協同合作,打造更貼合產業需求的劃片機解決方案,助力我國IC集成電路封裝產業突破關鍵技術瓶頸,提升全球競爭力,為半導體產業鏈自主可控發展注入強勁動力。
138-2371-2890
